05 Raster-Sonden-Mikroskopie (RSM)
Fakultät
Elektrotechnik und MedientechnikStandort
Technische Hochschule DeggendorfAnwendungsmöglichkeiten
Durch die Teilnahme am Praktikum „Ausgewählte Kapitel der Mikro- und Nanoelektronik“ erlernen die Studierenden, dass es neben der Raster-Elektronen-Mikroskopie, eine Vielzahl von Verfahren der Raster-Sonden-Mikroskopie gibt, mit denen Material- und Strukturparameter von mikro- und nanotechnologischen Systemen analysiert werden können. Das Ziel ist die Erlernung der Funktionsweisen unterschiedlicher SPM-Messmodi sowie die Befähigung zum praktischen Umgang mit Raster-Sonden-Mikroskopen. Die Praktikumsversuche vertiefen die theoretischen Grundkenntnisse von Mikro- und Nanosystemen und gewähren Einblicke in die Anwendung höchstauflösender SPM-Analysemethoden.
Leistungsspektrum:
- Halbleiteranalytik
- Oberflächenanalytik
- Raster-Sonden-Mikroskopie
Messmodi:
- Topographie (Tapping)
- Scanning Capacitance (SCM)
- Scanning Spreading Resistance (SSRM)
- Kelvin-Probe-Force (KPFM)
- Tunneling Current (TUNA, C-AFM)
- Scanning Magnetic Force (MFM)
- Harmonix
- Nano Scratch & Nano Wear
- Quantitative Nanomechanical Property Mapping (QNM)
Praktikumsinhalte:
- Einführung Raster-Sonden-Mikroskopie
- Rauhigkeits-Oberflächenanalyse einer präparierten Probe
- Scanning Capacitance Microscopy (SCM)
- Scanning Spreading Resistance Microscopy (SSRM)
- Conductive Atomic Force Microscopy (CAFM)
- Magnetic Force Microscopy (MFM)
- Tunnelstrommessungen (TUNA)
- Oxiddickenbestimmung Durchführung von Bachelor- und Masterarbeiten sowie von Forschungsprojekten auf den Gebieten der Raster-Sonden-Mikroskopie.
Das Labor richtet sich primär an Studierende der Technischen Hochschule Deggendorf.
Technische Daten
Raum: L006, E015
Ausstattung
- 2 x AFM "Dimension 3100" der Firma Bruker mit Nanoscope IIIa Controller
- AFM „Dimension Icon“ der Firma Bruker mit Nanoscope V Controller
- TUNA Applikationsmodul
- SCM Applicationsmodul
- Topographiemessungen: es können Oberflächenbilder mit einer Höhenauflösung von unter einem nm erzeugt werden
- SCM: Kombinierte Topographie- und Oberflächenkapazitätsmessung
- TUNA: Kombinierte Topographie- und Oberflächenkapazitätsmessungen bis in den pA-Bereich
- Elektrische Potential- und Kraftmessung
- MFM: Magnetic Force Microscopy Charakterisierung magnetischer Eigenschaften
- Mechanische Charakterisierung: Nanoidentation, -scratching, -wear, -friction

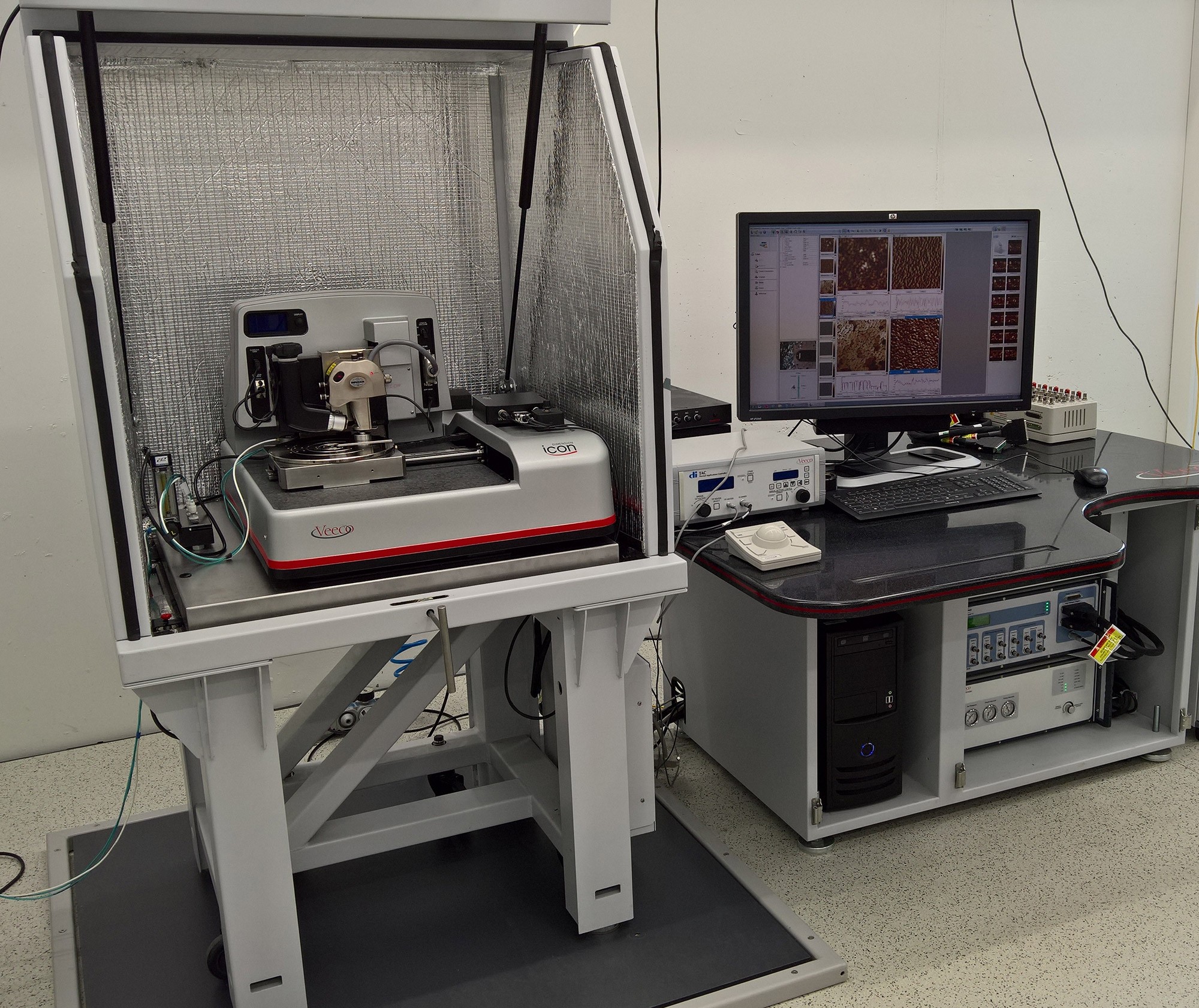


 Version: 2.2.1-qf2
Version: 2.2.1-qf2